因?yàn)閷?zhuān)業(yè)
所以領(lǐng)先


車(chē)規(guī)級(jí)碳化硅(SiC)功率模塊因其高效率、高功率密度和優(yōu)異的高溫性能,正在成為電動(dòng)汽車(chē)和新能源領(lǐng)域的核心技術(shù)之一。下面我將從關(guān)鍵材料、封裝流程和市場(chǎng)應(yīng)用三個(gè)方面為你進(jìn)行分析。
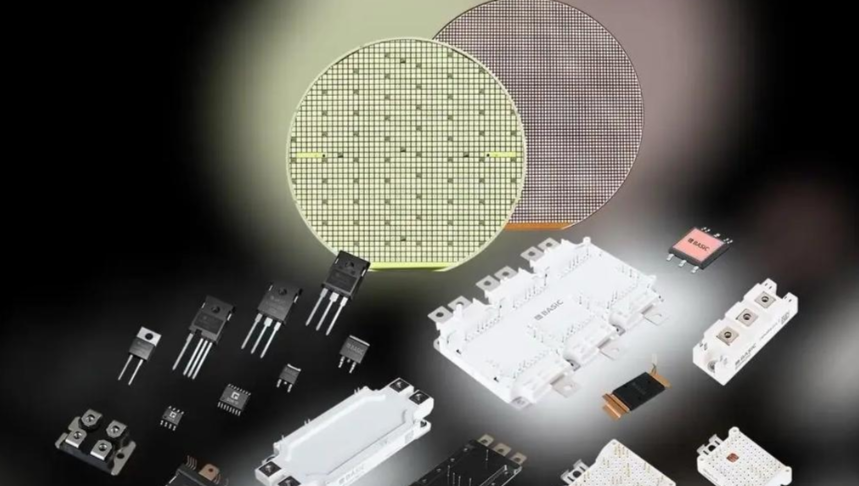
車(chē)規(guī)級(jí)碳化硅(SiC)功率模塊憑借其高開(kāi)關(guān)頻率、低損耗、高結(jié)溫工作能力和優(yōu)異的熱性能,正在逐步取代傳統(tǒng)硅基IGBT,成為電動(dòng)汽車(chē)電驅(qū)系統(tǒng)、充電基礎(chǔ)設(shè)施等高要求應(yīng)用場(chǎng)景的首選。其采用先進(jìn)的封裝材料(如納米銀燒結(jié)膏、AMB基板)和創(chuàng)新的互連技術(shù)(如雙面散熱、Cu-Clip綁定),實(shí)現(xiàn)了更低的寄生電感(可達(dá)3nH以下)和更高的可靠性,滿足了汽車(chē)電子對(duì)效率和功率密度的嚴(yán)苛需求。
車(chē)規(guī)級(jí)SiC功率模塊的性能和可靠性在很大程度上依賴(lài)于其構(gòu)成材料。
SiC MOSFET芯片:相比傳統(tǒng)硅基IGBT,SiC芯片具有更高的禁帶寬度(~3.2eV)、更高的臨界擊穿電場(chǎng)和更高的熱導(dǎo)率。這使得SiC器件能在更高溫度、更高電壓和更高頻率下工作。芯片厚度通常在180μm左右(如Tesla Model 3中采用的芯片)。
陶瓷基板:用于電氣絕緣和散熱。常見(jiàn)類(lèi)型包括:
芯片貼裝材料:傳統(tǒng)焊錫膏正逐漸被納米銀燒結(jié)膏取代。納米銀燒結(jié)具有5倍以上的導(dǎo)熱性能和10倍以上的可靠性,能顯著降低熱阻并提高模塊的壽命。芯片焊接空洞率能控制在1%左右。
互聯(lián)材料:
封裝外殼:傳統(tǒng)環(huán)氧樹(shù)脂模注料仍在使用,但PPS(聚苯硫醚) 等高性能工程塑料應(yīng)用增多,因其耐溫特性好、機(jī)械強(qiáng)度高。
散熱材料:基板底部常采用燒結(jié)銀技術(shù)與散熱器互聯(lián),省去了導(dǎo)熱絕緣墊片,降低了熱阻。
車(chē)規(guī)級(jí)SiC功率模塊的封裝不僅要求高性能,還需滿足汽車(chē)級(jí)的高可靠性和自動(dòng)化生產(chǎn)需求。
典型的封裝流程主要包括以下步驟,但會(huì)因具體設(shè)計(jì)和工藝而異:
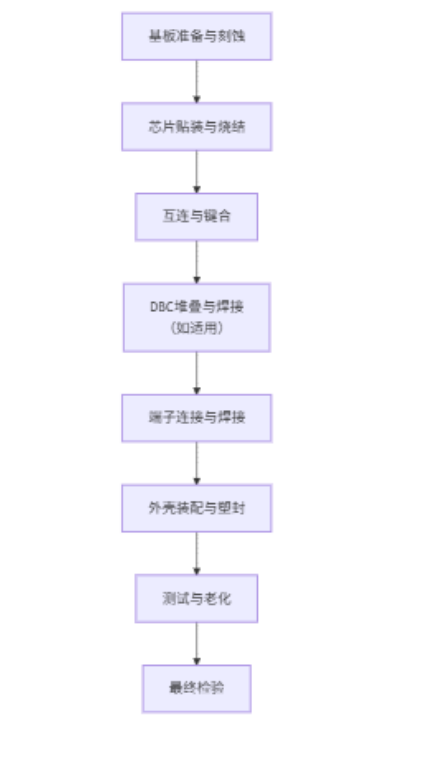
芯片貼裝:通過(guò)真空回流焊接或銀燒結(jié)工藝將SiC芯片精確地貼裝到基板上。銀燒結(jié)需要在高溫高壓下進(jìn)行,以確保低空洞率和良好的熱機(jī)械性能。
互連工藝:
DBC堆疊與連接(對(duì)于創(chuàng)新封裝):對(duì)于采用多堆疊DBC單元的設(shè)計(jì),需要將頂層DBC焊接到底層DBC上,并使用連接器或三維端子在不同DBC單元之間實(shí)現(xiàn)電氣連接。
端子焊接:將功率端子和信號(hào)端子焊接到相應(yīng)的基板或引線框架上。
外殼與塑封:采用轉(zhuǎn)移注塑成型工藝將模塊用環(huán)氧樹(shù)脂或PPS塑料封裝起來(lái),以實(shí)現(xiàn)環(huán)境保護(hù)、機(jī)械保護(hù)和電氣絕緣。對(duì)于雙面散熱模塊,注塑過(guò)程需要獨(dú)特的轉(zhuǎn)模注塑工藝。
測(cè)試與老化:進(jìn)行高壓測(cè)試、功能測(cè)試和高溫老化測(cè)試,以確保模塊的可靠性和耐久性,滿足車(chē)規(guī)標(biāo)準(zhǔn)(如AQG 324)。
為了充分發(fā)揮SiC的性能,許多創(chuàng)新封裝技術(shù)被開(kāi)發(fā)出來(lái):
多堆疊DBC單元:將整個(gè)模塊基板分割成多個(gè)更小的DBC單元進(jìn)行堆疊,利用互感對(duì)消效應(yīng)減小寄生電感(可降低74.8%),并提高設(shè)計(jì)自由度和生產(chǎn)良率。
無(wú)引線互連:采用Lead Frame或Cu-Clip取代大部分鍵合線,減小寄生參數(shù),提高可靠性和功率密度。
塑封技術(shù):全塑封模塊能更好地保護(hù)內(nèi)部結(jié)構(gòu),適應(yīng)惡劣環(huán)境。采用納米銀燒結(jié)、粗引線鍵合等工藝可顯著提高可靠性。

車(chē)規(guī)級(jí)SiC功率模塊的市場(chǎng)增長(zhǎng)迅猛,其主要驅(qū)動(dòng)力來(lái)自于新能源汽車(chē)產(chǎn)業(yè)的蓬勃發(fā)展。
根據(jù)QYResearch調(diào)研,2024年全球車(chē)規(guī)級(jí)SiC功率模塊市場(chǎng)銷(xiāo)售額達(dá)到了26.46億美元,預(yù)計(jì)2031年市場(chǎng)規(guī)模將增長(zhǎng)至117.6億美元,2025-2031期間年復(fù)合增長(zhǎng)率(CAGR)高達(dá)24.1%。
汽車(chē)已成為碳化硅功率器件最大的下游市場(chǎng),2023年全球新能源汽車(chē)總銷(xiāo)量達(dá)1465.3萬(wàn)輛,其中中國(guó)銷(xiāo)量占比64.8%(949.5萬(wàn)輛),連續(xù)8年位居全球第一。
車(chē)規(guī)級(jí)SiC模塊主要應(yīng)用于以下幾個(gè)領(lǐng)域:
| 應(yīng)用領(lǐng)域 | 作用描述 | 優(yōu)勢(shì)體現(xiàn) | 電壓等級(jí) |
| 主驅(qū)逆變器 (核心應(yīng)用) | 將電池直流電轉(zhuǎn)換為交流電驅(qū)動(dòng)電機(jī) | 提升效率(3-5%),縮減體積(1/10),延長(zhǎng)續(xù)航(5-10%) | 1200V (主流) |
| 車(chē)載充電機(jī)(OBC) | 將交流電轉(zhuǎn)換為直流電為電池充電 | 提高充電效率,支持高功率快充 | 650V, 750V, 900V |
| DC-DC轉(zhuǎn)換器 | 進(jìn)行不同電壓等級(jí)間的轉(zhuǎn)換 | 提高轉(zhuǎn)換效率,減小系統(tǒng)尺寸 | |
| 充電樁 (非車(chē)載) | 提供快速充電服務(wù) | 提高充電功率和效率,減少能耗 | 1200V, 1700V |
全球車(chē)規(guī)級(jí)SiC功率模塊市場(chǎng)目前由幾家國(guó)際巨頭主導(dǎo),但中國(guó)廠商正在快速崛起。
國(guó)際主要廠商:意法半導(dǎo)體(STMicroelectronics)(特斯拉主要供應(yīng)商)、英飛凌(Infineon)、Wolfspeed、羅姆(Rohm)、安森美(Onsemi) 等。前三大廠商占據(jù)了全球約70%的市場(chǎng)份額。
中國(guó)主要廠商:比亞迪半導(dǎo)體、芯聯(lián)集成、廣東芯聚能、基本半導(dǎo)體、中車(chē)時(shí)代電氣、斯達(dá)半導(dǎo)等。按收入計(jì),2024年中國(guó)市場(chǎng)前七大廠商占據(jù)了約94%的份額。比亞迪在其漢EV車(chē)型上搭載了自主研發(fā)的SiC模塊。
驅(qū)動(dòng)因素:
新能源汽車(chē)800V高壓平臺(tái)的推廣:對(duì)1200V及以上的SiC模塊需求激增。
追求續(xù)航里程和快充效率:SiC模塊能有效提升系統(tǒng)效率,緩解里程焦慮,支持大電流快充。
成本下降:隨著襯底技術(shù)成熟和產(chǎn)能擴(kuò)張,SiC器件成本正以每年10%-15%的速度下降,加速其普及。
面臨挑戰(zhàn):
電壓等級(jí)升級(jí):隨著800V甚至更高電壓平臺(tái)成為主流,1700V的SiC模塊(如工研院開(kāi)發(fā)的型號(hào))將在充電樁等領(lǐng)域獲得更廣泛應(yīng)用。
封裝技術(shù)持續(xù)創(chuàng)新:追求更低的寄生電感(<3nH)、更低的熱阻和更高的功率密度。三維封裝、集成化封裝(如將驅(qū)動(dòng)、傳感、控制集成于一體)是重要方向。
成本優(yōu)化與國(guó)產(chǎn)替代:通過(guò)材料創(chuàng)新、工藝優(yōu)化和規(guī)模效應(yīng)持續(xù)降本。中國(guó)廠商將逐步突破技術(shù)壁壘,提升在全球供應(yīng)鏈中的地位和市場(chǎng)份額。
應(yīng)用領(lǐng)域拓展:除新能源汽車(chē)外,SiC功率模塊還將在光伏逆變、工業(yè)控制、醫(yī)療器械等領(lǐng)域展現(xiàn)更大潛力。
車(chē)規(guī)級(jí)SiC功率模塊通過(guò)采用先進(jìn)的寬禁帶半導(dǎo)體芯片、高性能的封裝材料(如納米銀、AMB基板)和創(chuàng)新的互連與封裝技術(shù)(如雙面散熱、多堆疊DBC、Cu-Clip),成功實(shí)現(xiàn)了高效率、高功率密度、高可靠性的設(shè)計(jì)目標(biāo),成為推動(dòng)電動(dòng)汽車(chē)發(fā)展的關(guān)鍵技術(shù)之一。
其市場(chǎng)應(yīng)用以新能源汽車(chē)主驅(qū)逆變器為核心,并覆蓋OBC、DC-DC及充電樁等領(lǐng)域,市場(chǎng)增長(zhǎng)迅速且未來(lái)可期。雖然目前產(chǎn)業(yè)仍面臨成本、技術(shù)和供應(yīng)鏈方面的挑戰(zhàn),但隨著技術(shù)的不斷成熟和成本的持續(xù)下降,SiC功率模塊必將在更廣闊的領(lǐng)域發(fā)揮重要作用,并呈現(xiàn)出電壓等級(jí)升級(jí)、封裝集成化更高、國(guó)產(chǎn)替代加速等未來(lái)趨勢(shì)。
車(chē)規(guī)級(jí)SiC功率模塊清洗劑-合明科技芯片封裝前錫膏助焊劑清洗劑介紹:
水基清洗的工藝和設(shè)備配置選擇對(duì)清洗精密器件尤其重要,一旦選定,就會(huì)作為一個(gè)長(zhǎng)期的使用和運(yùn)行方式。水基清洗劑必須滿足清洗、漂洗、干燥的全工藝流程。
污染物有多種,可歸納為離子型和非離子型兩大類(lèi)。離子型污染物接觸到環(huán)境中的濕氣,通電后發(fā)生電化學(xué)遷移,形成樹(shù)枝狀結(jié)構(gòu)體,造成低電阻通路,破壞了電路板功能。非離子型污染物可穿透PC B 的絕緣層,在PCB板表層下生長(zhǎng)枝晶。除了離子型和非離子型污染物,還有粒狀污染物,例如焊料球、焊料槽內(nèi)的浮點(diǎn)、灰塵、塵埃等,這些污染物會(huì)導(dǎo)致焊點(diǎn)質(zhì)量降低、焊接時(shí)焊點(diǎn)拉尖、產(chǎn)生氣孔、短路等等多種不良現(xiàn)象。
這么多污染物,到底哪些才是最備受關(guān)注的呢?助焊劑或錫膏普遍應(yīng)用于回流焊和波峰焊工藝中,它們主要由溶劑、潤(rùn)濕劑、樹(shù)脂、緩蝕劑和活化劑等多種成分,焊后必然存在熱改性生成物,這些物質(zhì)在所有污染物中的占據(jù)主導(dǎo),從產(chǎn)品失效情況來(lái)而言,焊后殘余物是影響產(chǎn)品質(zhì)量最主要的影響因素,離子型殘留物易引起電遷移使絕緣電阻下降,松香樹(shù)脂殘留物易吸附灰塵或雜質(zhì)引發(fā)接觸電阻增大,嚴(yán)重者導(dǎo)致開(kāi)路失效,因此焊后必須進(jìn)行嚴(yán)格的清洗,才能保障電路板的質(zhì)量。
合明科技研發(fā)的水基清洗劑配合合適的清洗工藝能為芯片封裝前提供潔凈的界面條件。
合明科技運(yùn)用自身原創(chuàng)的產(chǎn)品技術(shù),滿足芯片封裝工藝制程清洗的高難度技術(shù)要求,打破國(guó)外廠商在行業(yè)中的壟斷地位,為芯片封裝材料全面國(guó)產(chǎn)自主提供強(qiáng)有力的支持。
推薦使用合明科技水基清洗劑產(chǎn)品。
合明科技致力于為SMT電子表面貼裝清洗、功率電子器件清洗及先進(jìn)封裝清洗提供高品質(zhì)、高技術(shù)、高價(jià)值的產(chǎn)品和服務(wù)。合明科技 (13691709838)Unibright 是一家集研發(fā)、生產(chǎn)、銷(xiāo)售為一體的國(guó)家高新技術(shù)、專(zhuān)精特新企業(yè),具有二十多年的水基清洗工藝解決方案服務(wù)經(jīng)驗(yàn),掌握電子制程環(huán)保水基清洗核心技術(shù)。水基技術(shù)產(chǎn)品覆蓋從半導(dǎo)體芯片封測(cè)到 PCBA 組件終端的清洗應(yīng)用。是IPC-CH-65B CN《清洗指導(dǎo)》標(biāo)準(zhǔn)的單位。合明科技全系列產(chǎn)品均為自主研發(fā),具有深厚的技術(shù)開(kāi)發(fā)能力,擁有五十多項(xiàng)知識(shí)產(chǎn)權(quán)、專(zhuān)利,是國(guó)內(nèi)為數(shù)不多擁有完整的電子制程清洗產(chǎn)品鏈的公司。合明科技致力成為芯片、電子精密清洗劑的領(lǐng)先者。以國(guó)內(nèi)自有品牌,以完善的服務(wù)體系,高效的經(jīng)營(yíng)管理機(jī)制、雄厚的技術(shù)研發(fā)實(shí)力和產(chǎn)品價(jià)格優(yōu)勢(shì),為國(guó)內(nèi)企業(yè)、機(jī)構(gòu)提供更好的技術(shù)服務(wù)和更優(yōu)質(zhì)的產(chǎn)品。合明科技的定位不僅是精湛技術(shù)產(chǎn)品的提供商,另外更具價(jià)值的是能為客戶(hù)提供可行的材料、工藝、設(shè)備綜合解決方案,為客戶(hù)解決各類(lèi)高端精密電子、芯片封裝制程清洗中的難題,理順工藝,提高良率,成為客戶(hù)可靠的幫手。
合明科技憑借精湛的產(chǎn)品技術(shù)水平受邀成為國(guó)際電子工業(yè)連接協(xié)會(huì)技術(shù)組主席單位,編寫(xiě)全球首部中文版《清洗指導(dǎo)》IPC標(biāo)準(zhǔn)(標(biāo)準(zhǔn)編號(hào):IPC-CH-65B CN)(“Guidelines for Cleaning of Printed Boards and Assemblies”),IPC標(biāo)準(zhǔn)是全球電子行業(yè)優(yōu)先選用標(biāo)準(zhǔn),是集成電路材料產(chǎn)業(yè)技術(shù)創(chuàng)新聯(lián)盟會(huì)員成員。
主營(yíng)產(chǎn)品包括:集成電路與先進(jìn)封裝清洗材料、電子焊接助焊劑、電子環(huán)保清洗設(shè)備、電子輔料等。
半導(dǎo)體技術(shù)應(yīng)用節(jié)點(diǎn):FlipChip ;2D/2.5D/3D堆疊集成;COB綁定前清洗;晶圓級(jí)封裝;高密度SIP焊后清洗;功率電子清洗。

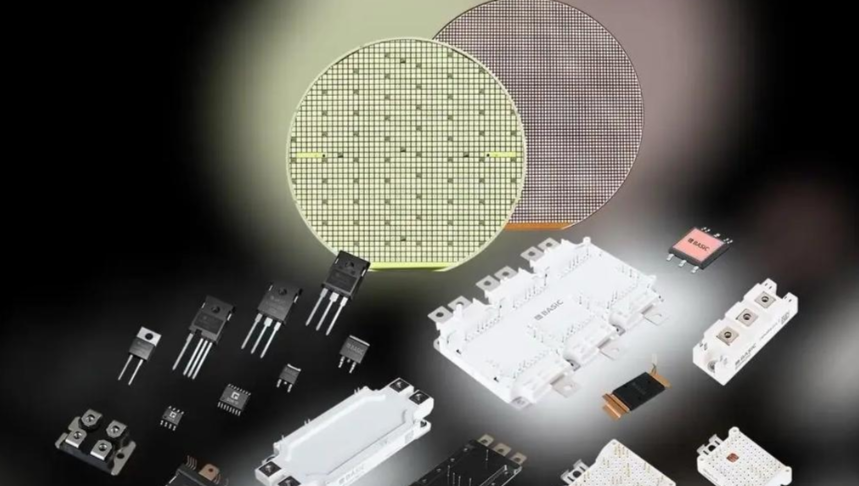



![[x]](/template/default/picture/closeimgfz1.svg)